
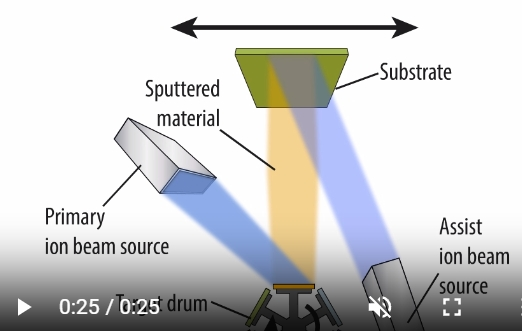
离子束溅射:用于先进应用的密集高精度涂层
离子束溅射(IBS)也被称为离子束沉积或离子束溅射沉积(IBSD),是一种在衬底上产生特别密集、均匀和无缺陷的薄膜的PVD技术。
一个聚焦的宽离子束用惰性气体离子,如氦或氮轰击目标物质。离子与具有高动能的目标表面碰撞,喷出材料中的单个粒子(原子或分子),使它们凝结在衬底表面形成薄薄的涂层。通过在一个加工室中使用不同的目标,可以生产出高质量的多层层,即所谓的多层涂层。
与磁控溅射或蒸发等PVD技术相比,离子束溅射具有若干优点。射出的微粒以高能量击中衬底物。因此,它们具有较高的表面流动性,很容易在已经沉积的颗粒之间嵌入,从而形成特别密集和无缺陷的层。低溅射压力和低工艺温度使密集的膜生长和优良的膜性能。此外,离子束能量是精确可调的,允许更大程度地控制沉积层的性质,包括密度,附着力和成分。
离子束溅射的一种特殊形式是 双离子束溅射 或双离子束沉积。通过添加辅助离子束源,第二次离子轰击可以影响衬底上的生长膜或预清洗衬底。
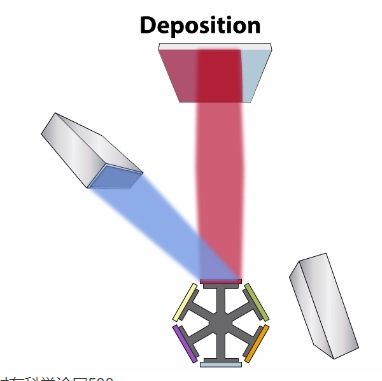
1、Scia Coat200
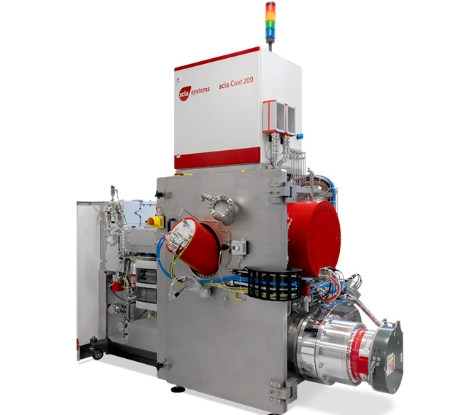
200层-最多200毫米的晶圆上的多层沉积
离子束溅射
双离子束溅射
离子束蚀刻
高品质多层沉积
… 200号外套 具有良好的均匀性涂料在200毫米底材。用离子束喷溅沉积代替其它沉积工艺,可以获得光滑无缺陷的薄膜。现场光学监测确保了良好的过程稳定性。此外,该系统能够处理晶圆片以及任意形状的基板。
特点和益处
底物旋转和倾斜均匀性优异
将最多5个水冷目标材料放在旋转保持器上进行原地变换
采用石英晶体振荡器和(或)光学厚度监测器(ODM)和测试玻璃变换器来控制多层沉积
直接晶圆处理或根据不同的基板尺寸和载波处理进行调整
配有350毫米离子束源作为辅助源,也可用于离子束蚀刻过程
应用程序
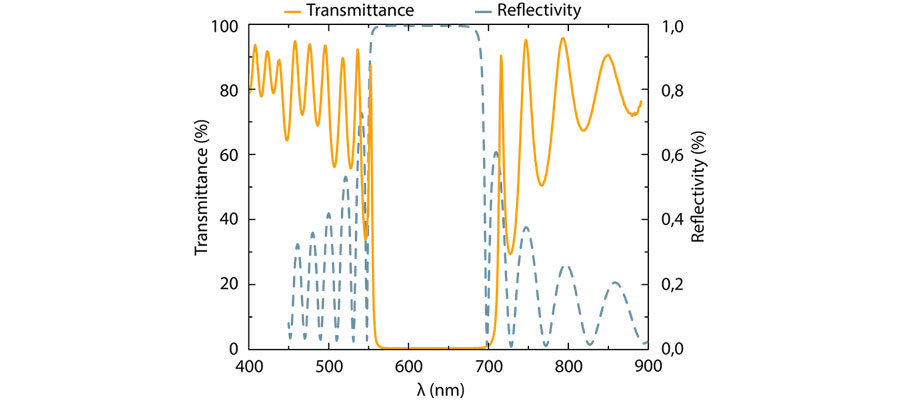
高反射镜的发射率和反射率图。高反射镜@630纳米四分之一波堆的沉积。反射率为99.9%,透过率为15-20百万。
高反光层的光学涂料、带通和缺口滤波器
用于磁传感器的多层薄膜(转基因、TMR、涡流电子)
高激光损伤阈值涂料
介质和金属层的沉积
预处理基板(蚀刻、清洗、平滑)
申请书
电涂料 在大基板上
高反光涂料 和他一起 2 O 5 以及氧化硅 2
原则
主要来源使材料从一个目标到垂直或面朝下定向衬底
用于预先清洗衬底和/或在沉积过程中辅助的次要来源

技术
离子束溅射 这样,材料就会从一个具有离子束的目标上喷出,并沉积在衬底上。
双离子束溅射 使用额外的辅助离子束源来影响生长膜.
离子束蚀刻 使用惰性气体离子的准直束结构或材料去除。
底板尺寸(最大) | 200毫米口径。 |
基座 | 水冷、氦背面冷却接触,衬底旋转5-20分钟,可在0-170°每0.1°的位置旋转 |
离子束源 | 发射源:120毫米环形射频源(RF120-E) |
中和器 | 丝丝驱动或射频驱动等离子体桥中和器 |
目标持有者 | 目标桶与倾斜和水冷目标,最多5(每个最大。220毫米口径。)或最多4(最多每次。300毫米口径。) |
碱压 | < 5 x 10 -7 马巴 |
系统尺寸(WxDxH) | 3.10Mx1.70米x2.40米,适用于带磁带处理的单室(没有电器架和泵) |
配置 | 单室,带单衬底负载锁定或磁带处理,集群系统,带磁带处理 |
软件接口 | SECS II / GEM, OPC |
典型沉积速率:
空气质量:35纳米/分钟
铝:10纳米/分钟
硅:15纳米/分钟
钛:8纳米/分钟
铝合金 2 O 3 15纳米/分钟
高级官员 2 20纳米/分钟
塔 2 O 5 15纳米/分钟
蒂奥 2 6纳米/分钟
均匀性变异 | ≤ 0.5 % (σ/mean) |
2、Scia Coat 500

咨询电话:13522079385
SIDA涂层500-大面积精密光学多层涂层
离子束溅射
双离子束溅射
离子束蚀刻
大面积多层沉积
… 工作服500 用于大基板的均匀涂层,用于精密光学。配方控制沉积过程允许多层堆栈的可重复性。因此,一个可改变的塑造系统(最多4个塑造系统)可以补偿参数和/或材料依赖的不均匀性影响,并能够沉积定义的梯度薄膜。
特点和益处
由于直线运动的良好均匀性
可将多达6个水冷目标材料放在旋转保持器上进行原地变换
采用石英晶体振荡器和(或)光学厚度监测器(ORT)控制的多层沉积
用于梯度涂层或表面误差校正的线性轴系统的控制运动
可选择的衬底加热到250℃,以优化膜应力
应用程序

80层多层堆栈的X射线反射率测量及拟合曲线。第四级布拉格峰可见性表明单层厚度具有很好的重复性。
光学滤波器、X射线镜和同步镜用多层膜
高反光层和介质层的光学涂料
具有性质梯度的薄膜的沉积(Gg-PALB镜子)
离子束平滑
一元离子束图
申请书
电涂料 在大基板上
高反光涂料 和他一起 2 O 5 以及氧化硅 2
原则
主要来源使材料从目标到面向面的衬底物
用于预先清洗衬底和/或在沉积过程中辅助的次要来源
技术
离子束溅射 这样,材料就会从一个具有离子束的目标上喷出,并沉积在衬底上。
双离子束溅射 使用额外的辅助离子束源来影响生长膜.
离子束蚀刻 使用惰性气体离子的准直束结构或材料去除。
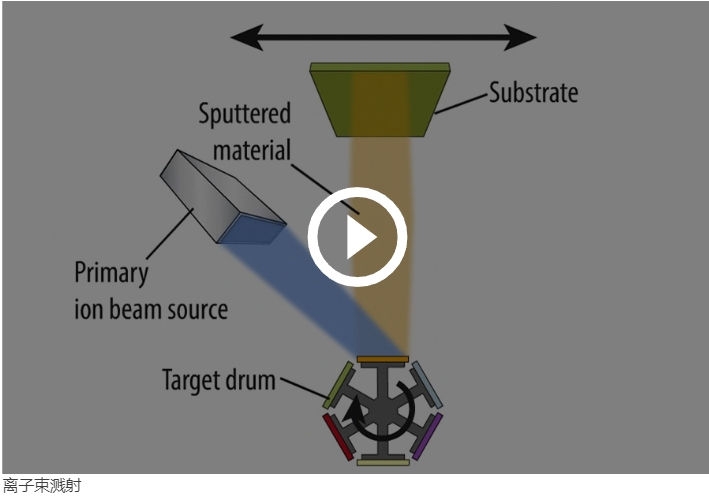
底板尺寸(最大) | 500毫米x300毫米,300毫米直径。轮调 |
基座 | 直线运动从0.1毫米/分钟到15毫米/秒,旋转最多300转(最大。300毫米口径。) |
离子束源 | 2个380毫米线性微波ECR源(LIN380-E) |
中和器 | 丝丝驱动等离子桥中和器 |
目标持有者 | 目标桶,最多6个可倾斜和水冷却目标(每个最大)。400毫米x200毫米) |
碱压 | < 5 x 10 -8 马巴 |
系统尺寸(WxDxH) | 3.30米x1.70米x2.00米(无电动机架和水泵) |
配置 | 单室,可选择的单基板负载锁定基板最多200毫米直径。 |
软件接口 | SECS II / GEM, OPC |
3、Scia Opto 300
高到300毫米的精密光学涂层.
离子束溅射
双离子束溅射
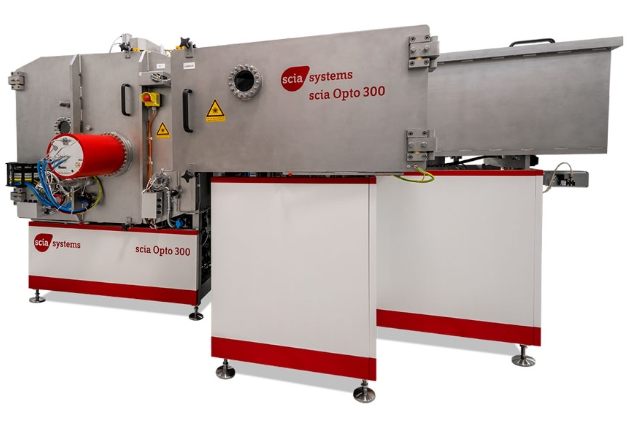
光学涂层的精密度
… 约300 用于精密光学的均匀涂层。多层弹性沉积的目标多达6个,甚至可以混合目标材料。两个装载位置允许连续和完全自动的处理衬底.光学现场监测与集成测试玻璃更换器,确保最高精度和优化均匀的涂层。
特点和益处
可变化的衬底尺寸最多300毫米直径.
自动装载,有两个装载位置,供连续处理
最多6个可旋转的目标材料,每个目标最多300毫米x300毫米,具有混合层或层与层之间平稳过渡的最佳几何结构
最大不超过60RPM的衬底旋转具有优异的工艺均匀性
光学厚度监视器和测试玻璃改变器
低应力涂层的优化几何
应用程序

应用实例:由TA2O5构成的多层堆栈的抗反射涂料
在TGG上的SO2,设计用于633纳米典型激光线的透明度。
图左边:层叠结构图右边:用椭圆计的传输方式测量的传输光谱.可达到反射率的目标值。
光电镜(例如:角状过滤器)
高反光层的光学涂料、带通和缺口滤波器
高激光损伤阈值涂料
折射率梯度层的沉积
预处理基板(蚀刻、清洗、平滑)
金属、种子和保护涂层
原则
主要来源使材料从目标到面朝下定向衬底
用于预先清洗衬底和/或在沉积过程中辅助的次要来源
技术
离子束溅射 这样,材料就会从一个具有离子束的目标上喷出,并沉积在衬底上。
双离子束溅射 使用额外的辅助离子束源来影响生长膜.
.
底板尺寸(最大) | 300毫米口径。 |
基座 | 基座旋转至60rPM,包括光学厚度监视器(Om)和测试玻璃改变器 |
离子束源 | 发射源:120毫米环形射频源(RF120-E) |
中和器 | 高频驱动等离子桥中和器 |
目标持有者 | 有6个水冷目标的目标桶(每个目标最多300毫米x300毫米) |
碱压 | < 5 x 10 -8 马巴 |
系统尺寸(WxDxH) | 对于带有双层衬底负载锁定的单室(没有电架和泵),4.60米x1.80米x2.20米 |
配置 | 带有双衬底负载锁定的单室 |
软件接口 | SECS II / GEM, OPC |
典型沉积速率 | Si: 6 nm/min, SiO 2 :9纳米/分钟,塔 2 O 5 6纳米/分钟 |
均匀性变异 | ≤ 0.8 % (σ/mean) for 300 mm |