

1、日本DISCO芯片分割机DDS2010

兼顾小型芯片元器件产品在隐形切割TM分割时的高成品率和高生产效率
Φ200 mm
SDTT
切实地分割小芯片晶圆
由于可对隐形切割加工后的晶圆进行高成品率,高生产效率的分割,因此只要一台机器便可对应扩片(Expand)和裂片(Breaking) 。
※将激光聚焦在加工物内部产生变质层,再利用胶膜扩片等方法进行晶圆分割的切割方法。可有效减少IC标签和线传感器等小芯片/长芯片等产品元件的切割道。
高生产效率
通过采用不受芯片尺寸约束,以一定的速度进行晶圆分割的扫描裂片,相比与每条线都需停止才能进行分割的三点弯曲裂片,可缩短分割时间。
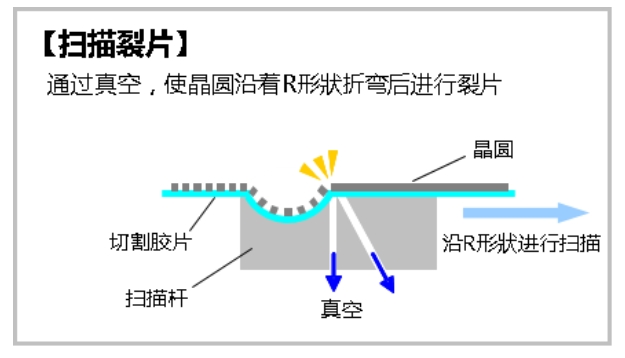
胶膜扩片+扫描裂片
将胶膜扩片后仍未分割的芯片用扫描杆进行裂片,可抑制芯片的未分割。
晶圆分割后,可在保持芯片间距离的状态下,转贴到与晶圆直径尺寸相同的胶膜框架上。
大幅度的缩短分割时间
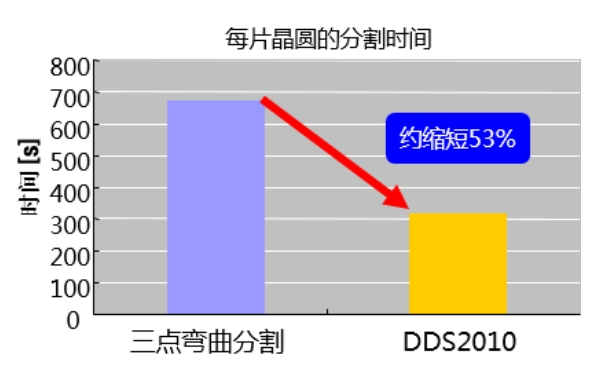
晶圆 Φ8 inch x 0.1 mm thick
Si芯片尺寸 0.5 × 0.5 mm
注1:数值为本公司的实测值
注2:加工时间为个例,在不同条件下结果有所不同
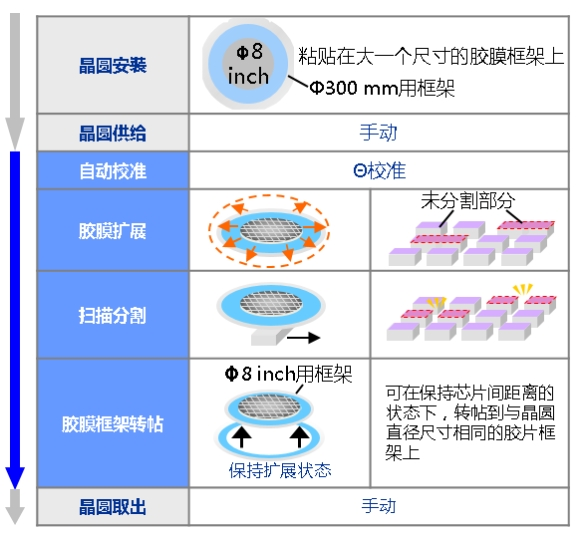
Process flow
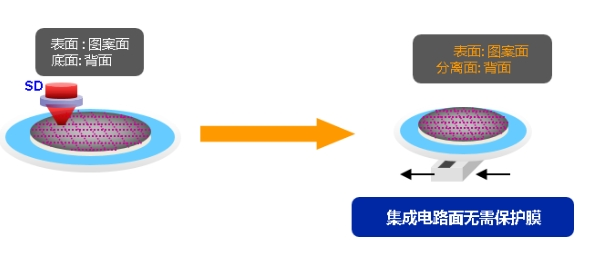
分割时集成电路面无需保护膜
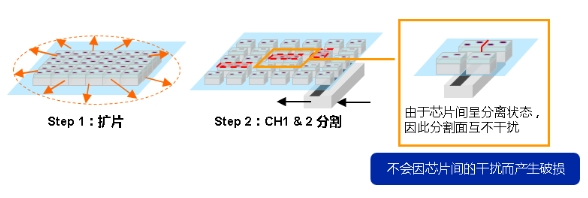
通过预先扩片,防止分割时的破损
技术规格
Specification Unit
Max. workpiece size - Φ8 inch
Dice size mm 0.1~0.5 (narrow side)
Max. 20 mm (long side) *long die only
Wafer mounting accuracy X/Y direction (frame mount) mm ±2.5
Wafer mounting accuracy θ direction (frame mount) ° ±3°
Equipment dimensions (W×D×H) mm 718 × 897 × 1,608 (including status indicator)
Equipment weight kg Approx.450
※为了改善,机器的外观,特征,规格等本公司可能在未预先通知用户的情况下实施变更。
※使用时,请先确认标准规格书。
2、日本DISCO芯片分割机DDS2300

高品质DAF分割的芯片分割设备
Φ300 mm
SDBG
SDTT
提高粘贴于DAF上的薄晶圆分割品质
在有DAF(Die Attach Film)的薄晶圆分割工艺中,全切割时会面临切割面上发生DAF毛边(Burr), 或在贴片工艺时发生pick up不良等课题。在切割工艺中采用DDS2300可提高DAF的切割品质,可改善以上课题。
有效于DBG工艺后的DAF切割
在适合于薄芯片制造的DBG(Dicing Before Grinding)工艺中使用DAF时,在已被分割成芯片的背面粘贴DAF之后,需要只切割DAF的工艺。用以往的激光加工方法切断DAF时,需要表面保护溶液等消耗品。采用DDS2300可抑制激光对DAF的切割深度,以减少加工碎屑,有望大幅度地降低消耗品的成本。
实现隐形切割TM加工后稳定的芯片分割
可实现对隐形切割后在内部形成变质层的晶圆进行稳定的芯片分割。
这是对粘贴有DAF的薄晶圆进行隐形切割时,特别有效的制程工艺。
通过冷扩片提高DAF分割品质
为稳定地分割DAF而采用冷扩片方式。利用DAF在低温时会脆化的特性,在低温的环境下进行扩展,实现高品质的DAF分割。
通过胶膜框架搬送,顺畅地进入下一工序
通过热收缩可消除扩展后在切割胶带外围所产生的松弛。不必重新贴换胶膜,可直接将胶膜框架送往贴片工序(die bonding process)。

咨询电话:13522079385
适用的应用例
隐形切割加工后的DAF分割
DBG后的DAF分割
隐形切割后的芯片分割
工作流程系统
取物夹将加工物从晶圆盒取出,送往框架定位平台 →
在框架定位平台定位后,送往中间平台 →
移至冷扩展台上,进行冷扩展 →
移至热扩展台上,再次进行扩展· 热收缩 →
移至离心清洗台上,进行清洗 干燥 →
移至UV照射台上,进行UV照射 →
取物夹将加工物收回晶圆盒内
技术规格
Specification Unit
Max. workpiece size mm Φ300
Cooler stage Temperature setting range ℃ 0 or -5 (fixed)
(setting when shipped from the Plant)
Max. upthrust amount mm 30
Upthrust amount setting range mm 0 ~ 30 (step 0.001)
Max. upthrust speed mm/s 400
Upthrust speed setting range mm/s 0.001 ~ 400 (step 0.001)
Heat shrink stage Hot air temperature setting range ℃ 200 or 220 or 250 (selective)
Max. upthrust amount mm 20
Upthrust amount setting range mm 0 ~ 20 (step 0.001)
Max. up thrust speed mm/s 50
Upthrust speed setting range mm/s 0.001 ~ 50 (step 0.001)
Equipment dimensions (W×D×H) mm 1,200 × 1,550 × 1,800
Equipment weight kg Approx.900
3、日本DISCO芯片分割机DDS2310

针对小芯片晶圆分割的芯片分割设备
Φ300 mm
SDBG
SDTT
实现隐形切割TM加工后稳定的小型芯片分割
可实现对隐形切割加工后在内部形成变质层的晶圆进行高品质的芯片分割。
特别有效于使用隐形切割加工小型芯片的场合。
保持扩宽且均匀的切痕
通过为小芯片的分割而开发的热扩工作盘以及FIR(Far Infrared/远红外线)加热器,使小芯片也可保持足够宽度的切痕。
标准搭配4个FIR加热器,提高生产效率
通过搭载4个FIR加热器,提高胶膜的收缩性能,实现小芯片分割生产效率的提高
通过冷扩片提高DAF分割品质
通过采用冷扩片方式,不仅对小芯片分割,而且对DAF分割,都能实施稳定的分割。
通过胶膜框架搬送,顺畅地进入下一工序
通过热收缩可消除扩展后在切割胶带外围所产生的松弛。不必重新贴换胶膜,可直接将胶膜框架送往贴片工序(die bonding process)。
适用的应用例
隐形切割加工后的DAF分割
DBG后的DAF分割
隐形切割后的芯片分割
工作流程系统
取物夹将加工物从晶圆盒取出,送往框架定位平台 →
在框架定位平台定位后,送往中间平台 →
移至冷扩展台上,进行冷扩展 →
移至热扩展台上,再次进行扩展· 热收缩 →
移至离心清洗台上,进行清洗 干燥 →
移至UV照射台(特别附属品)上,进行UV照射 →
取物夹将加工物收回晶圆盒内

技术规格
Specification Unit
Max. workpiece size mm Φ300
Cooler stage Temperature setting range ℃ 0 or -5 (fixed)
(setting when shipped from the Plant)
Max. upthrust amount mm 30
Upthrust amount setting range mm 0~30 (step 0.001)
Max. upthrust speed mm/s 400
Upthrust speed setting range mm/s 0.001 ~ 400 (step 0.001)
Heat shrink stage Temperature setting range ℃ 400 ~ 600
Max. upthrust amount mm 20
Upthrust amount setting range mm 0 ~ 20 (step 0.001)
Max. up thrust speed mm/s 50
Upthrust speed setting range mm/s 0.001 ~ 50 (step 0.001)
Equipment dimensions (W×D×H) mm 1,200 × 1,800 × 1,955
Equipment weight kg Approx.1,000
4、日本DISCO芯片分割机DDS2320

通过有针对性的功能强化
实现面向Memory市场(大型芯片)的高产能・高信赖性的芯片分割机
Φ300 mm
SDBG
SDTT
SDBG (Stealth Dicing Before Grinding) 工艺后,稳定的芯片分割
实现对隐形切割加工后内部形成改质层的晶片和粘有DAF的芯片进行稳定的分割。
实现高产能并提高加工后Device的可靠度
通过采用新开发的扩片单元以及工件反转机构,实现高产能的同时,提高了Device的可靠度。
实现高产能
冷扩张及热收缩的一体化
在同一扩片单元内实现冷扩张和热收缩。和以往机型相比,省略了需在两单元间的工件传送的步骤,实现了产能的提高,且降低了传送过程中破片的风险。
双扩片单元的并列加工
通过搭载2个扩片单元,实现并列加工,可期待对产能的提高。除此之外和以往机型相同,在热收缩后可以直接以Tape Frame的方式进入Die Bounding工序。
提高加工后Device的信赖度
通过将工件反转后的搬运/加工/清洗,减少了碎屑的附着。以此提高Device的信赖度和良率。
反转冷扩张・热收缩
通过将工件面朝下进行冷扩张・热收缩的工艺,促使在芯片分割・胶膜收缩时所发生的碎屑下落、防止其二次附着。
反转SP的清洗・搬运
保持芯片化后的工件面朝下的状态,进行SP清洗。通过上述工艺,抑制了碎屑的二次附着。
削减约40%的空间占有率
以往机型需要在本体的周围设置复数的配套机械,通过将配套机械的内置化,实现了空间的节省。
技术规格
规格 单位
最大工件尺寸 mm Φ300
(只对应Φ12inch Tape Frame)
扩片机台 温度设定范围 ℃ -2~30℃(可変)
最大扩片上顶量 mm 30
扩片上顶量 设定范围 mm 0 ~30 (Step 0.001)
最大扩片上顶速度 mm/s 400
扩片上顶速度 设定范围 mm/s 0.001 ~ 400 (step 0.001)
温风、温度设定范围 ℃ 150~250℃(可変)
温风、流量设定范围 L/mm 0~30(可変)
设备尺寸 (W×D×H) mm 1,300 × 1,800 × 1,800
设备重量 kg 约1,126